| Оборудование Компоненты Сервис |
Москва, Нижний Сусальный пер. 5, стр. 4
|
Универсальная установка для совмещения и экспонирования SUSS MA/BA6 Gen2

Ручная установка совмещения и экспонирования для контактной литографии и бондинга с расширенными возможностями. Обработка пластин до 150 мм.
MA6 (установку совмещения пластин) легко перепрофилировать на совмещение подложек для склейки (бондинга), эта система носит название BA6.
В результате обновления линейки оборудования SUSS Microtec, взамен популярной MA6 Gen 2 с июня 2019 года поставляется улучшенная модель SUSS MA/BA 6/8 Gen 4
 Возможность двухэтапной приемки
Возможность двухэтапной приемки на заводе производителе
Основные возможности:
- Совмещение сверху/снизу и ИК
- Точное установление зазора
- Высококачественная оптика с уменьшением дифракции позволяет достичь высокого разрешения
- Оптимальное качество края при толстом резисте
- Надежное субмикронное разрешение
- Возможность работы с хрупкими пластинами и кусочками
- Прецизионный модуль фиксации (и безфиксационная опция) совмещенных пластин для бондинга
- Опция для Нано импринтинга
- Опция Голографии ближнего поля для создания двухмерных оптических структур
- Работа с пластинами от 2 дюймов до 150 мм (подложки 2Х2 до 6Х6 дюймов)
- Работа с кусочками менее 5 мм
Инжиниринговые услуги:
Системы виброзащиты оборудованияМАКСИМАЛЬНАЯ ГИБКОСТЬ ДЛЯ РАЗЛИЧНЫХ ПРИМЕНЕНИЙ
Содержание:
Применение
Совмещение
Экспонирующая оптика
Экспонирование
Импринт литография
Установка совмещения и экспонирования SUSS MA6 Gen2 всегда считалась образцом в полупроводниковой промышленности. Она широко используется в НИОКР и производстве 3D-микросистем. Система отвечает современным требованиям по гибкости конфигурации, точности и соотношению цена/качество. MA6 Gen2 позволяет перенести лабораторный (пилотный) процесс в массовое производство, т. к. базовые узлы этой установки и промышленной SUSS MA150 совпадают. МА6 Gen2 спроектирована для всех стандартных применений в литографии.
Для производства MEMS с толстым фоторезистом MA6 Gen2 предлагает оптику с высоким разрешением и уменьшенной дифракцией для оптимального качества края. Опция совмещения снизу позволяет экспонировать на обе стороны подложки. В дополнение MA6 предлагает специальные средства для работы с хрупкими АIII-ВV материалами, утоненными пластинами и прозрачными подложками. MA6 Gen2 легко перепрофилировать на совмещение подложек для склейки (бондинга), эта система носит название BA6 Gen2.
ОПЦИИ
- Высокая точность совмещения для сращивания
- Импринт-литография для всей пластины и печать на малых площадях структур в нанометрическом диапазоне
- Моделирующее ПО

МЭМC
Благодаря экспонирующей оптике высокой интенсивности система MA/BA6 Gen2 обеспечивает эффективную поддержку процессов с толстопленочным резистом в области МЭМС. Совмещение с задней стороны или в ИК-свете (проходящее или отражающее излучение), совмещение для сращивания и возможность обработки любого типа подложек превращают MA/BA6 Gen2 в универсальное устройство для разработки и мелкосерийного производства МЭМС-устройств.

Научно-исследовательская деятельность
MA/BA6 Gen2 обеспечивает гибкость и простоту эксплуатации, благодаря чему является основным выбором для процессов, связанных с научно-исследовательской деятельностью. При использовании наноимпринт литографии, совмещении для сращивания или литографии с толстопленочным фоторезистом переход между процессами выполняется очень быстро, обеспечивая полную гибкость. В линейке оборудования есть экономичные модели с ручной настройкой для базовых исследований, а также полностью моторизованные системы.
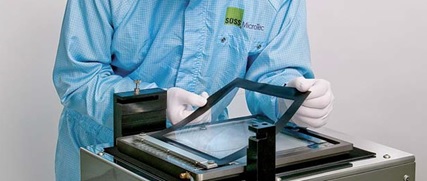
3D-СТРУКТУРИРОВАНИЕ
Установка совмещения и экспонирования MA/BA6 Gen2 охватывает все аспекты решений наноимпринт литографии - от высокого до низкого разрешения на малой или большой площади. Опция UV-NIL направлена на печать с высоким разрешением на малых подложках. Для импринтинга по всей площади пластины размером до 150 мм оптимальным выбором будет уникальная технология SCIL.
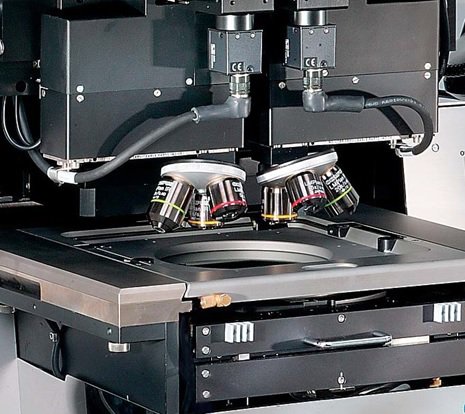
Совмещение с верхней стороны (TSA)
Система MA/BA6 Gen2 оснащена моторизованной системой совмещения с верхней стороны, с помощью которой можно добиться точности совмещения ± 0.5 мкм. Дополнительные объективы позволяют оператору легко переключаться между различными увеличениями.
Совмещение с нижней стороны (BSA)
Помимо совмещения с верхней стороны для многих применений, таких как МЭМС требуется точное совмещение с нижней стороны. MA/BA6 Gen2 можно дополнительно оборудовать светлопольным микроскопами для совмещения с нижней стороны. Они имеют переключатель увеличения и позволяют добиться точности совмещения 1 мкм. В микроскопе для совмещения с нижней стороны с одним и двумя полями используются ПЗС-камеры высокого разрешения. Уникальная система хранения и обработки изображений в режиме реального времени точнее и быстрее, чем стандартное совмещение с перекрестием.
ИК-совмещение (IR)
Совмещение в инфракрасном свете позволяет обрабатывать непрозрачные материалы, которые прозрачны для ИК-излучения, например GaAs, InP, кремний или адгезивы, которые используются при работе с тонкими пластинами или в процессах инкапсуляции. Установка совмещения и экспонирования MA/BA6 Gen2 может быть оснащена модулем проходящей или отраженной ИК-подсветки, который монтируется на стандартный BSA-микроскоп.
|
УЛУЧШЕННАЯ СИСТЕМА ХРАНЕНИЯ ИЗОБРАЖЕНИЙ (EISS) Система хранения изображений компании SUSS MicroTec отвечает самым строгим требованиям совмещения. Среди возможностей: SVGA-разрешение и усиление контрастности, а также регулировка яркости сохраненных изображений. |
СОВМЕЩЕНИЕ С БОЛЬШИМ ЗАЗОРОМ Система MA/BA6 Gen2 оснащена опцией совмещения с большим зазором AL400, которая гарантирует высокоточное совмещение даже в случаях, когда требуется большой зазор между шаблоном и пластиной. |

Доступные оптические системы MA/BA6 Gen2
Оптика высокого разрешения (HR Optics)
- Оптика для совмещения с большим зазором (LGO)
- Оптика MO Exposure Optics (MOEO)
Оптика высокого разрешения
Специальные оптические компоненты высокого разрешения были оптимизированы для достижения лучших характеристик при экспонировании с контактом или небольшими зазорами. Оптика высокого разрешения позволяет добиться разрешений до 2.5 мкм при зазоре экспонирования 20 мкм и субмикронного разрешения при контакте.
Оптика для экспонирования с большим зазором
Данные оптические элементы предназначены для достижения высокого разрешения при экспонировании с большими расстояниями от шаблона до пластины с помощью настройки угла освещения. Эта оптика как правило используется для работы с подложками с плотной топографией или толстопленочным резистом.
Оптика MO EXPOSURE OPTICS
В основе этих экспонирующих элементов лежат уникальные микролинзы высокого качества в сочетании со сменной пластиной фильтра (IFP). Они обеспечивают превосходную равномерность освещения и позволяют легко переключаться между классической оптикой компании SUSS, оптикой HR и LGO. Экспонирующая оптика MO Exposure Optics позволяет получить освещение в соответствии с особыми требования благодаря модификации пластины IFP и использовать улучшенные технологии литографии, такие как оптимизация источник-шаблон (SMO) или оптическая коррекция зазора (OPC).

|
 |
|
| Сильные эффекты дифракции от параллельного освещения | уменьшающая дифракцию оптика компании SUSS |
Система уменьшения дифракции
Уникальная система экспонирования SUSS MicroTec сводит к минимуму эффекты дифракции на кромке, ограничивающие разрешения. Система позволяет проводить экспонирование под точным углом освещения для выравнивания напечатанных элементов – технология, которая приводит к существенному увеличению разрешения и производительности.
SUSS MicroTec является единственным поставщиком полупроводникового оборудования, который предлагает оптику для уменьшения дифракции.
Режимы экспонирования
Установка совмещения и экспонирования MA/BA6 Gen2 предлагает различные режимы экспонирования для выполнения любых требований широкого ряда применений. Для достижения максимального разрешения до субмикронного диапазона используется печать с вакуумным, мягким и жестким контактом. Печать с зазором используется, чтобы избежать какого-либо контакта шаблона с пластиной. Предупреждение загрязнения шаблона прямо влияет на повышение производительности.

Оптическая система установки совмещения и экспонирования SUSS MA/BA6 Gen2
Разрешение MA/BA6 Gen2
|
Режим экспонирования |
UV400 |
UV300 |
UV250 |
|---|---|---|---|
|
Вакуумный контакт |
< 0.8 мкм |
< 0.7 мкм | < 0.6 мкм |
|
Жесткий контакт |
< 1.5 мкм |
< 1.0 мкм |
- |
|
Мягкий контакт |
< 2.5 мкм | < 2.0 мкм |
- |
|
Зазор (20 мкм) |
< 3.0 мкм | < 2.5 мкм |
- |
Разрешение линий и пробелов на пластине из кремния размером 150 мм с резистом толщиной 1.2 мкм AZ 4110 (UV400, UV300) и резистом толщиной 0.8 мкм (UV6, UV250) respectively.
Доступное разрешение зависит от размера пластины, плоскостности пластины, типа резиста, условий чистой комнаты и, следовательно, может различаться в зависимости от процесса.
ВЫРАВНИВАНИЕ ПЛАСТИНЫ И КОНТРОЛЬ ЗАЗОРА ЭКСПОНИРОВАНИЯ
ТОЧНОСТЬ ДЛЯ САМОГО ВЫСОКОГО РАЗРЕШЕНИЯ
Точное выравнивание и контроль зазора пластины и шаблона является необходимым для оптимального CD-контроля. Он обеспечивает параллельность шаблона и подложки во время совмещения и экспонирования, а также точный контроль зазора, для исключения ошибок параллельности и достижения более высокого разрешения. Система выравнивания и калибровки зазора установки MA/BA6 Gen2 предназначена для выполнения самых жестких требований с учетом точности и надежности.
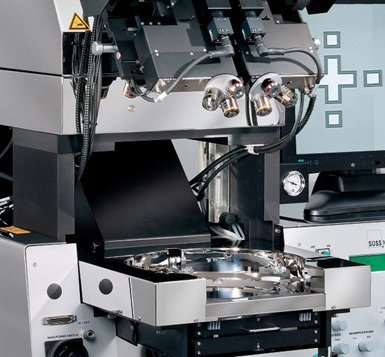
Совмещения для сращивания
MA/BA6 Gen2 предлагает функцию высокоточного совмещения для последующего сращивания полупроводниковых пластин. Система, основанная на технологии расширенного хранения изображений, позволяет добиться точности совмещения 0,5 мкм. Модуль предварительного сращивания поддерживает точность совмещения пластин во время ручного перемещения из установки совмещения в установку сращивания и гарантирует постоянный зазор между пластинами. Модуль либо встраивается в систему MA/BA6 Gen2 или доступен в виде отдельной установки предварительного совмещения для сращивания - SUSS BA6/8.
Сращивание методом сплавления
Установка совмещения и экспонирования MA/BA6 Gen2 позволяет проводить сращивание пластин методом сплавления. После совмещения две пластины приводятся в прямой контакт, и начинается процесс предварительного сращивания методом сплавления.
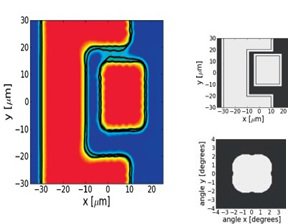
Моделирующее ПО LABВерсия моделирующего ПО компании SUSS объединяет все оптические решения SUSS MicroTec, такие как экспонирующая оптика HR, LGO и MO, включая их индивидуальные характеристики. ПО уменьшает необходимость в оптимизации и упрощает разработку процесса. Моделирующее ПО LAB вместе с оптикой MO является передовой технологией для получения лучшего результата, сокращая затрачиваемое на оптимизацию процесса время.
|
Дополнительные опции. Гибкость для выполнения любой задачи


Наноимпринт литография с УФ-излучением (UV-NIL)
Решения UV-NIL для наноструктур вполне могут стать инновационным подходом для полупроводниковых, МЭМС и оптоэлектронных технологий следующего поколения.
| Отпечатанные структуры, UV-NIL |
В литографии UV-NIL используются маленькие (1"x1") жесткие или мягкие штампы и УФ-отверждение в установке совмещения и экспонирования MA/BA6 Gen2. UV-NIL можно использовать, чтобы добиться разрешения до 50 нм, благодаря чему эта технология является экономичной и эффективной альтернативой электронно-лучевой литографии. Функционал UV-NIL можно добавить как отдельную систему или встроить в установку совмещения.
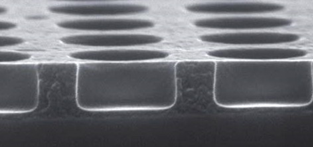
Импринт литография по большой площади (SCIL)
Импринт-литография по большой площади (SCIL) сочетает в себе преимущества мягкого составного штампа для нанесения рисунка на большую площадь с жесткой стеклянной подложкой для исключения искажения рисунка и лучшего разрешения.
| Отпечатанные структуры, SCIL |
В технологии SCIL используется принцип последовательного импринтинга с применением капиллярных сил, а не давления с задней стороны, что сводит к минимуму влияние воздуха даже на больших площадях и обеспечивает наилучшую однородность. Последовательное разделение штампа и подложки исключает высокую нагрузку и гарантирует чистое и надежное разделение без повреждения нанесенных структур.
| Шаблон и пластина/подложка | |
|---|---|
| Размер пластины | до 150 мм |
| Размер подложки | до 6" x 6" |
| Кусочки | до 5 x 5 мм |
| Размер шаблона | SEMI, стандартно до 7" x 7" |
| Режимы экспонирования | |
| Контакт | мягкий, жесткий, низкий вакуум, вакуум |
| Зазор | зазор экспонирования 1-999 мкм |
| Экспонирование по всему полю | Да |
| Точность настройки зазора | 1 мкм |
| Вакуумный контакт | регулируется до 200 мбар абс |
| Экспонирующая оптика | |
| Разрешение | до 0.5 мкм |
| Диапазон длин волн |
UV400 350 - 450 нм UV300 280 - 350 нм UV250 240 - 260 нм |
| Источник экспонирования |
Hg-лампы 200 - 1000 Вт HgXe- лампа 500 Вт |
| Равномерность интенсивности |
± 5 % ± 2.5 % (MO Exposure Optics) |
| Методы совмещения | |
| Совмещение с верхней стороны (TSA); Совмещение с нижней стороны (BSA); Совмещение в ИК (IR), Совмещение с большим зазором (AL300) | |
| Система совмещения с двойным фокусом AL400 | |
| Система совмещения с расширенным хранением изображений | |
| Точность TSA | до 0.5 мкм |
| Точность BSA | до 1 мкм |
| Зазор совмещения |
1 - 999 мкм 1 - 300 мкм (с AL300) |
| Платформа совмещения | |
| Диапазон перемещения |
X: ± 10 мм Y: ± 5 мм θ: ± 5° |
| Механическая точность | 0.1 мкм (размер шага) |
| Столик микроскопа TSA | |
| Однопольный микроскоп |
X: ± 25 мм Y: ± 25/-75мм |
| Микроскоп двойного поля |
X: ± 25 мм Y: ± 15/-75 мм; θ: ± 3° X: опц. ± 50 мм |
| Микроскоп TSA | |
| Однопольный микроскоп M500 | до 200 x |
| Микроскоп двойного поля M306 | до 335 x |
| DVM6 | до 1045 x (экран 17") |
| IRDVM6 | до 1045 x (экран 17") |
| Увеличение объектива |
стандартно 2.5x, 5 x, 10 x, 20 x опционно 5 x IR, 10 x IR |
| Разделение объективов микроскопа двойного поля |
С турелью: 32-160 мм Без турели: 27-160 мм |
| Микроскоп BSA с двойным полем | |
| Разделение объективов |
15 - 100 мм (62 - 148 мм опц.) |
| Диапазон перемещений | Y: + 50/- 20 мм |
| Увеличение | 112/355 на экране 17" |
| Поле обзора |
0.92 x 0.69 мм2 (высокое увеличение, одно поле) |
| Коммуникации | |
| Вакуум | <-0.8 бар, 200 мбар абс |
| Сжатый воздух | 5 бар (75 psi) |
| Азот | > 1 бар (15 psi) |
|
С лампой 350 Вт С лампой 1000 Вт |
0.3 м3/ч 0.9 м3/ч |
| Питание | |
| Питание | Напряжение AC 230 В |
|
|
Частота 50 - 60 Гц |
|
Потребление с:
Лампой 350 Вт
Лампой 500 Вт
Лампой 1000 ВТ |
1500 Вт 1700 Вт 2300 Вт |
| Габариты | |
| В x Ш x Г (LH1000) | 1570 x 1214 x 1300 мм |
| В x Ш x Г (LH350) | 1535 x 1214 x 1300 мм |
| Вес | 320 - 340 кг |

Suss LabSpin 6/8
Эти системы разработаны ...

Suss SB6/8 Gen2
Высокоточный бондер для ...

Suss RCD8
Платформа нанесения и ...

Suss AS 8/12
Уникальная система ...

Suss XB8
Высокоточный ...

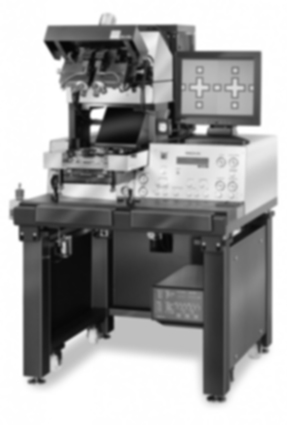




 495 287 8577
495 287 8577
 infos@tbs-semi.ru
infos@tbs-semi.ru

 Найти на карте
Найти на карте